

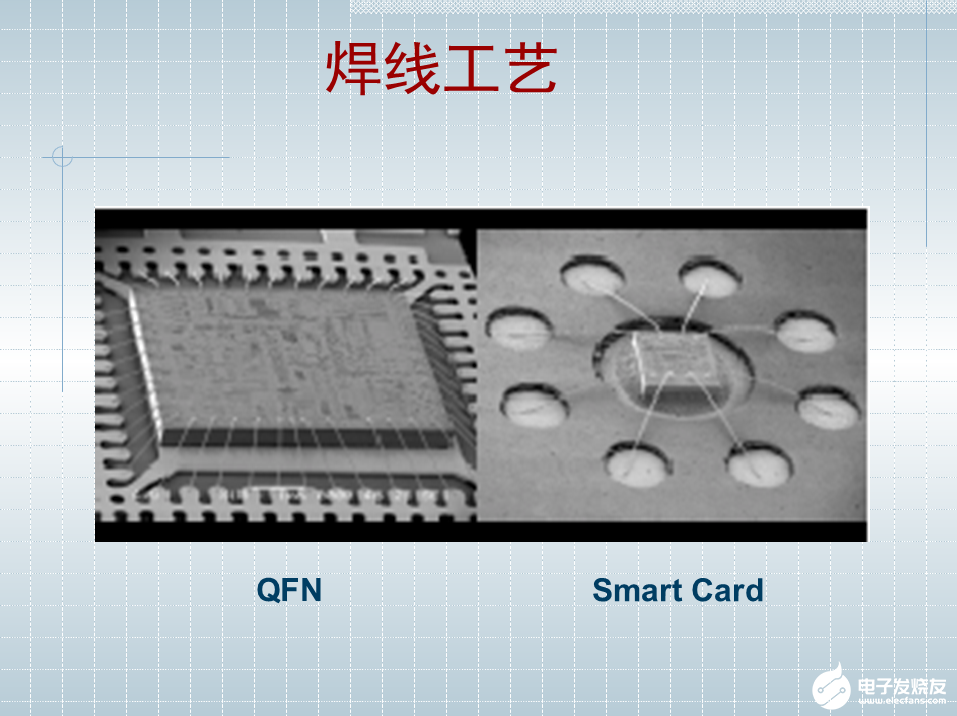





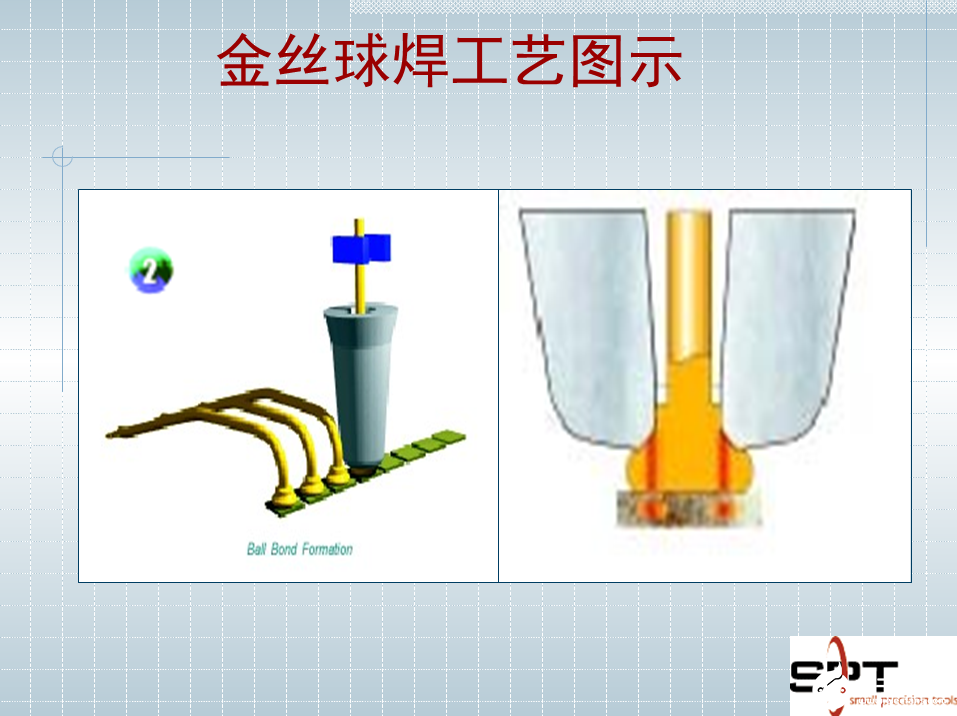



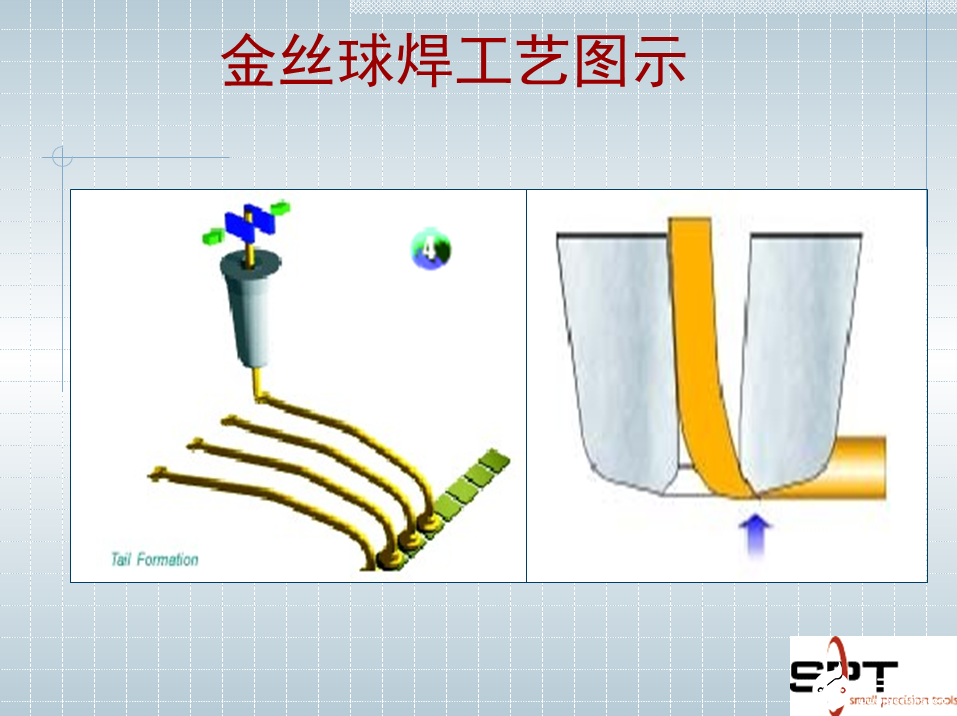




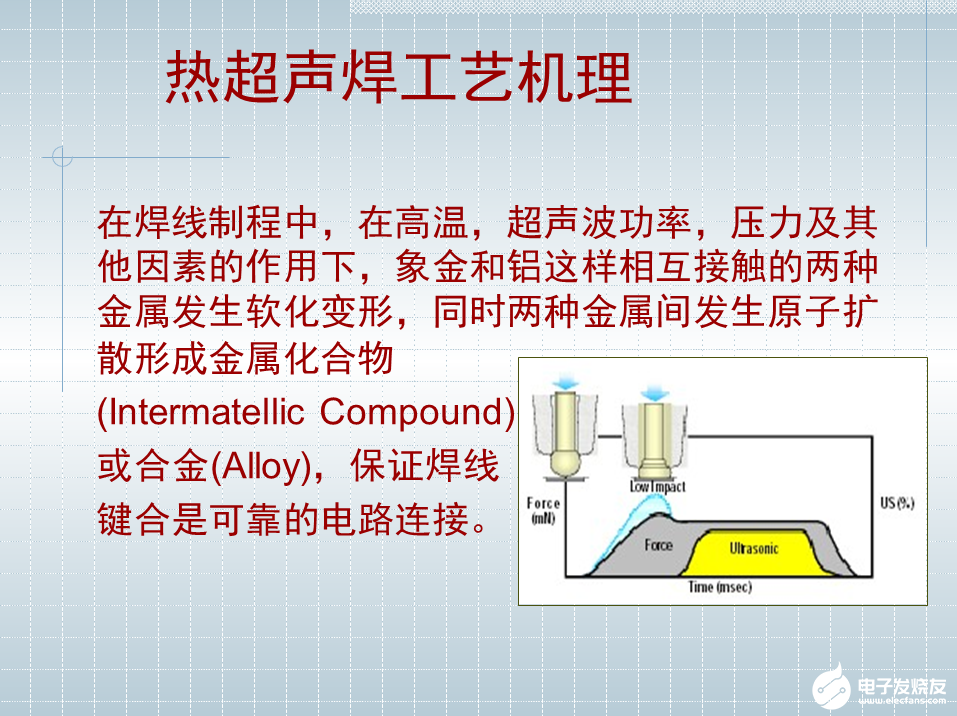
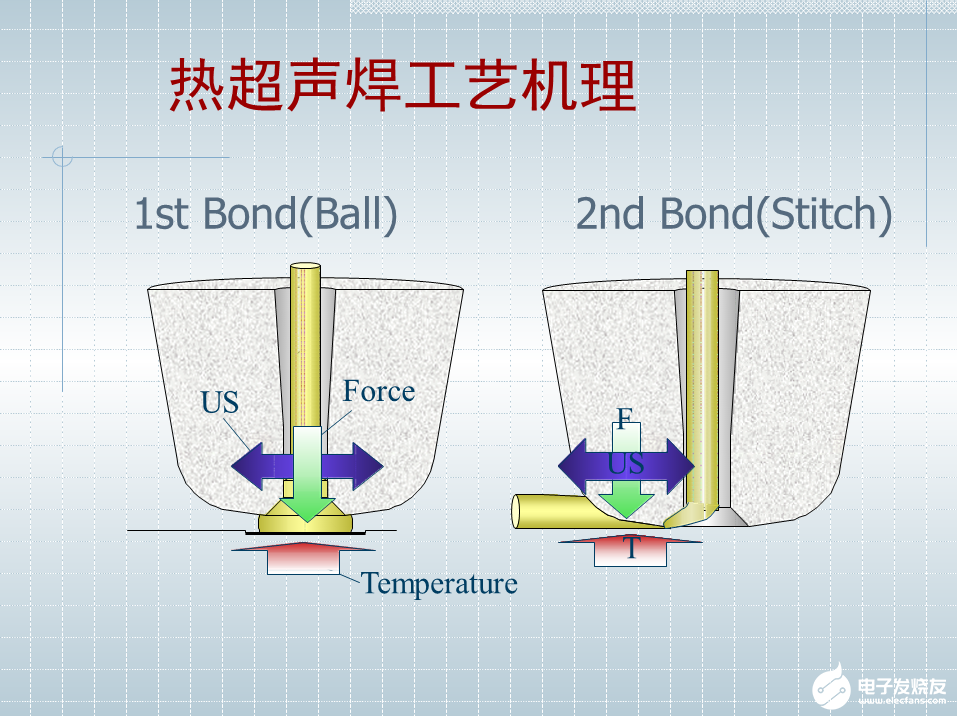






















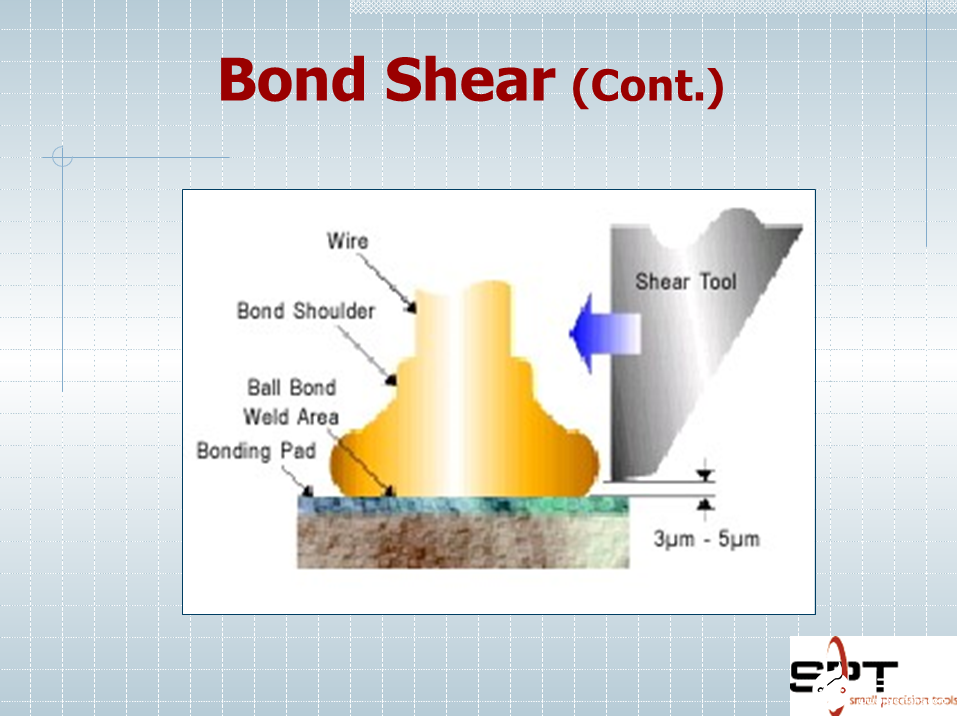

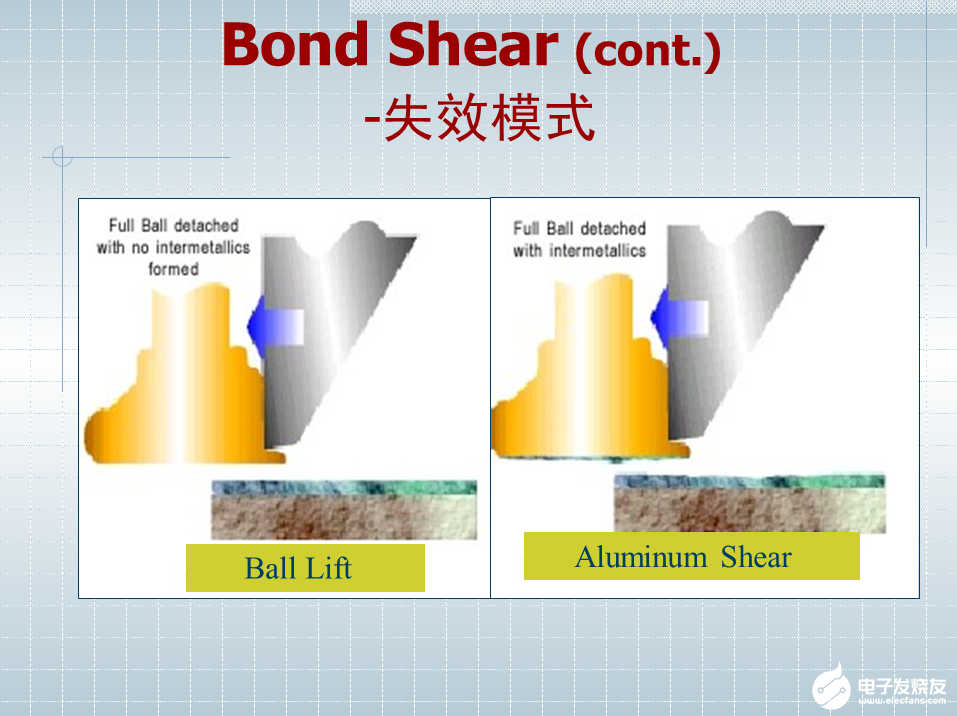
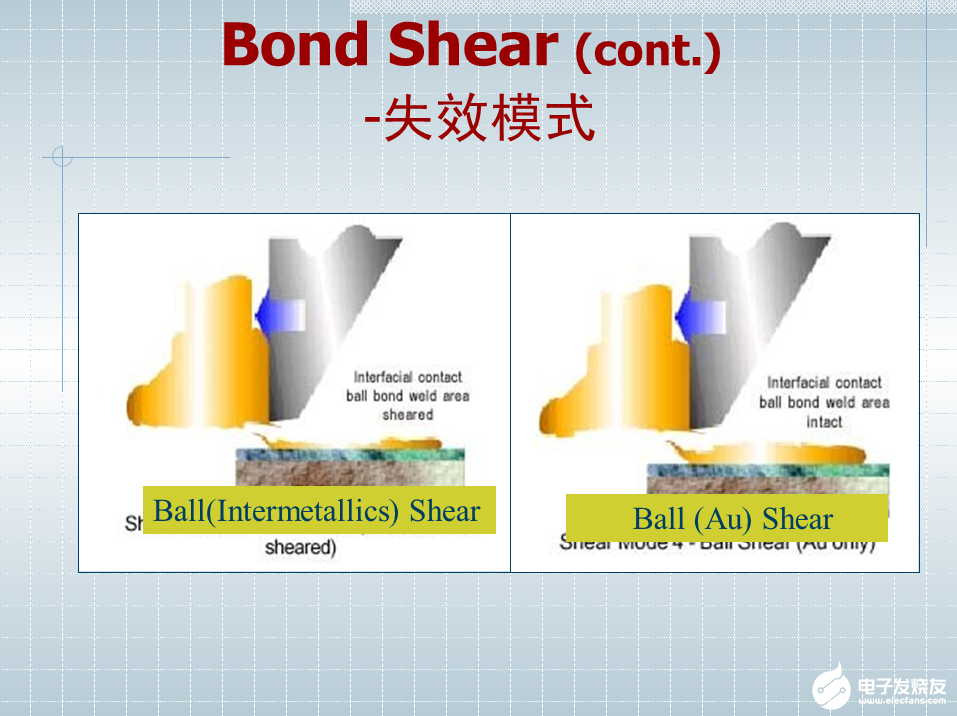
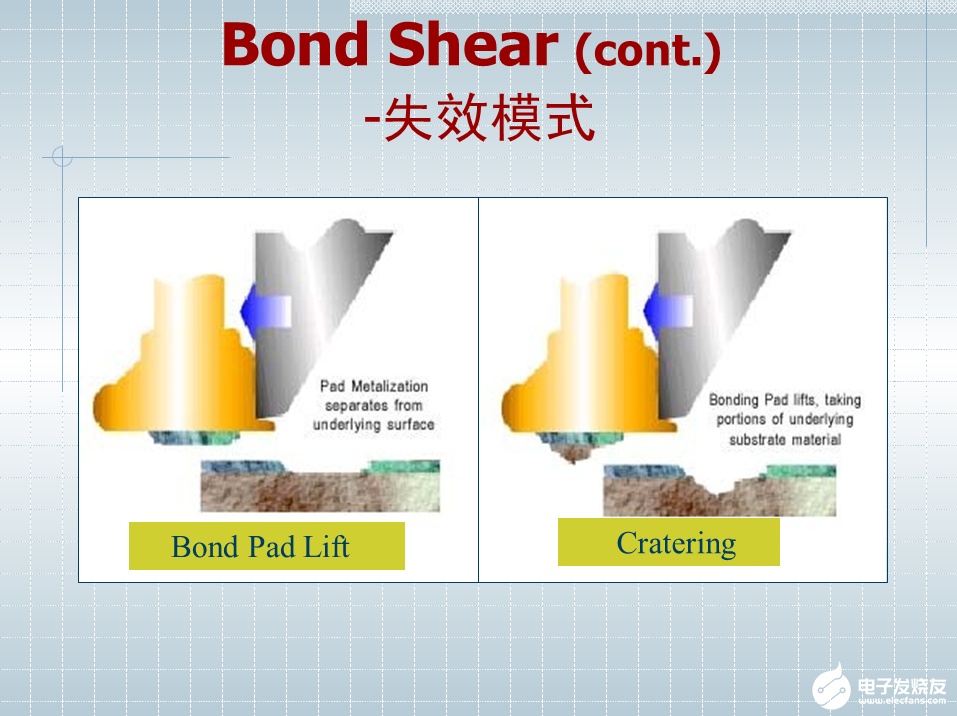





















聲明:本文內(nèi)容及配圖由入駐作者撰寫(xiě)或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點(diǎn)僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場(chǎng)。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問(wèn)題,請(qǐng)聯(lián)系本站處理。
舉報(bào)投訴
-
封裝
+關(guān)注
關(guān)注
128文章
9339瀏覽量
149081 -
鍵合
+關(guān)注
關(guān)注
0文章
107瀏覽量
8307
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
熱點(diǎn)推薦
有償求助本科畢業(yè)設(shè)計(jì)指導(dǎo)|引線(xiàn)鍵合|封裝工藝
。
通過(guò)實(shí)驗(yàn)驗(yàn)證和數(shù)據(jù)分析得出金絲與金鋁焊盤(pán)鍵合和鎳鈀金焊盤(pán)鍵合的工藝窗口和關(guān)鍵參數(shù),使其能滿(mǎn)足
發(fā)表于 03-10 14:14
connex金線(xiàn)鍵合機(jī)編程
本帖最后由 eehome 于 2013-1-5 10:11 編輯
connex金線(xiàn)鍵合機(jī)編程
發(fā)表于 05-19 09:03
MEMS工藝中的鍵合技術(shù)
鍵合技術(shù)是 MEMS 工藝中常用的技術(shù)之一,是指將硅片與硅片、硅片與玻璃或硅片與金屬等材料通過(guò)物理或化學(xué)反應(yīng)機(jī)制緊密結(jié)合在一起的一種
成本更低但鍵合性能相當(dāng)甚至更好的銅線(xiàn)來(lái)代替金線(xiàn)鍵合
金價(jià)不斷上漲增加了半導(dǎo)體制造業(yè)的成本壓力,因此業(yè)界一直在改善銅線(xiàn)的性能上努力,希望最終能夠用成本更低但鍵合性能相當(dāng)甚至更好的銅線(xiàn)來(lái)代替金線(xiàn)鍵
集成電路銅線(xiàn)鍵合工藝技術(shù)詳解
FSL已將消費(fèi)者1工業(yè)微控制器轉(zhuǎn)換為銅線(xiàn)和現(xiàn)在正在啟動(dòng)汽車(chē)改裝。
-金(金)和銅(銅)線(xiàn)都被用來(lái)連接到多年來(lái)集成電路上的鋁(AI)鍵墊金屬間化合物(IMC)的形成提供了電線(xiàn)和襯墊之間
發(fā)表于 03-08 14:30
?1168次閱讀
集成電路封裝基板工藝詳解(68頁(yè)PPT)
共讀好書(shū)歡迎掃碼添加小編微信掃碼加入知識(shí)星球,領(lǐng)取公眾號(hào)資料
原文標(biāo)題:集成電路封裝基板工藝詳解(68
晶圓鍵合工藝技術(shù)詳解(69頁(yè)PPT)
共讀好書(shū)歡迎掃碼添加小編微信掃碼加入知識(shí)星球,領(lǐng)取公眾號(hào)資料
原文標(biāo)題:晶圓鍵合工藝技術(shù)詳解
集成電路封裝基板工藝詳解(68頁(yè)PPT)
共讀好書(shū)歡迎掃碼添加小編微信掃碼加入知識(shí)星球,領(lǐng)取公眾號(hào)資料
原文標(biāo)題:集成電路封裝基板工藝詳解(68
芯片倒裝與線(xiàn)鍵合相比有哪些優(yōu)勢(shì)
中的定位與形態(tài)又是怎么樣的?本文將依次展開(kāi)敘述。 一、傳統(tǒng)線(xiàn)鍵合的局限性 線(xiàn)鍵合

電子元器件失效分析之金鋁鍵合
電子元器件封裝中的引線(xiàn)鍵合工藝,是實(shí)現(xiàn)芯片與外部世界連接的關(guān)鍵技術(shù)。其中,金鋁鍵合因其應(yīng)用廣泛、

熱壓鍵合工藝的技術(shù)原理和流程詳解
熱壓鍵合(Thermal Compression Bonding,TCB)是一種先進(jìn)的半導(dǎo)體封裝工藝技術(shù),通過(guò)同時(shí)施加熱量和壓力,將芯片與基板或其他材料緊密連接在一起。這種技術(shù)能夠在微

半導(dǎo)體金線(xiàn)鍵合(Gold Wire Bonding)封裝工藝技術(shù)簡(jiǎn)介;
如有雷同或是不當(dāng)之處,還請(qǐng)大家海涵。當(dāng)前在各網(wǎng)絡(luò)平臺(tái)上均以此昵稱(chēng)為ID跟大家一起交流學(xué)習(xí)! 在半導(dǎo)體封裝領(lǐng)域,隨著電子設(shè)備向更高性能、更小尺寸和更輕重量的方向發(fā)展,封裝技術(shù)的重要性日益凸顯。金線(xiàn)球焊




 金線(xiàn)鍵合工藝技術(shù)詳解(69頁(yè)P(yáng)PT)
金線(xiàn)鍵合工藝技術(shù)詳解(69頁(yè)P(yáng)PT)







評(píng)論