晶棒需要經(jīng)過一系列加工����,才能形成符合半導體制造要求的硅襯底�,即晶圓。加工的基本流程為:滾磨�、切斷、切....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-12 10:43
?5647次閱讀

SEM是一種功能強大的工具��,在材料科學�、生物學、納米技術(shù)和醫(yī)學研究等科學領(lǐng)域得到廣泛應用���,其常見用途....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-12 10:38
?2204次閱讀

本文主要講述TSV工藝中的硅晶圓減薄與銅平坦化�����。 硅晶圓減薄與銅平坦化作為 TSV 三維集成技術(shù)的核....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-12 10:35
?2166次閱讀

本文主要講述什么是系統(tǒng)級封裝技術(shù)����。 從封裝內(nèi)部的互連方式來看,主要包含引線鍵合���、倒裝��、硅通孔(TSV....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-05 15:09
?2699次閱讀

共晶焊接的核心是通過形成異種金屬間的共晶組織����,實現(xiàn)可靠牢固的金屬連接�。在半導體封裝的芯片安裝過程中,....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-05 15:06
?5302次閱讀

2.5D/3D封裝技術(shù)作為當前前沿的先進封裝工藝��,實現(xiàn)方案豐富多樣��,會根據(jù)不同應用需求和技術(shù)發(fā)展動態(tài)....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-05 15:03
?3726次閱讀

摩爾定律精準預言了近幾十年集成電路的發(fā)展�。然而,逐漸逼近的物理極限�、更高的性能需求和不再經(jīng)濟的工藝制....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-05 14:59
?3205次閱讀
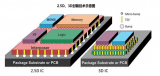
退火工藝是晶圓制造中的關(guān)鍵步驟,通過控制加熱和冷卻過程��,退火能夠緩解應力����、修復晶格缺陷、激活摻雜原子....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-01 09:35
?2982次閱讀

在無線通信中�����,接收器接收到的信號非常小�����,以至于系統(tǒng)中只能容忍有限的噪聲�����。因此���,對于電路設計人員來說��,....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-01 09:30
?4263次閱讀
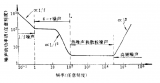
集成電路傳統(tǒng)封裝技術(shù)主要依據(jù)材料與管腳形態(tài)劃分:材料上采用金屬��、塑料或陶瓷管殼實現(xiàn)基礎(chǔ)封裝��;管腳結(jié)構(gòu)....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-01 09:27
?3830次閱讀

鍵合技術(shù)是通過溫度���、壓力等外部條件調(diào)控材料表面分子間作用力或化學鍵��,實現(xiàn)不同材料(如硅-硅�����、硅-玻璃....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-01 09:25
?2555次閱讀

在TSV制造技術(shù)中���,既包含TSV制造技術(shù)中通孔刻蝕與絕緣層的相關(guān)內(nèi)容。
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-01 09:24
?2577次閱讀

在芯片制造的最后環(huán)節(jié)���,裸片(Die)需要穿上“防護鎧甲”——既要抵抗物理損傷和化學腐蝕��,又要連接外部....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-01 09:22
?2051次閱讀
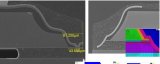
Gerber 文件是用于電子設計自動化(EDA)中�����,尤其是在印刷電路板(PCB)設計和制造過程中��,傳....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-01 09:20
?5365次閱讀
三維集成電路制造中����,對準技術(shù)是確保多層芯片鍵合精度、實現(xiàn)高密度TSV與金屬凸點正確互聯(lián)的核心技術(shù)���,直....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-01 09:16
?3736次閱讀

相較于傳統(tǒng)CMOS工藝���,TSV需應對高深寬比結(jié)構(gòu)帶來的技術(shù)挑戰(zhàn)����,從激光或深層離子反應刻蝕形成盲孔開始....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 08-01 09:13
?2662次閱讀
想象一下,你要為比沙粒還小的芯片建造“房屋”——既要保護其脆弱電路�,又要連接外部世界,還要解決散熱��、....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-31 10:14
?4047次閱讀
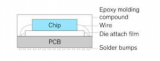
在半導體三維集成(3D IC)技術(shù)中��,硅通孔(TSV)是實現(xiàn)芯片垂直堆疊的核心�,但受深寬比限制,傳統(tǒng)....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-29 16:48
?2003次閱讀

絕緣體上硅(SOI)技術(shù)作為硅基集成電路領(lǐng)域的重要分支�,其核心特征在于通過埋氧層(BOX)實現(xiàn)有源層....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-28 15:27
?2856次閱讀
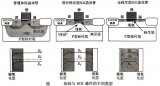
鎖相放大器是一種用于提取微弱信號的高精度電子儀器,能夠在強噪聲背景下檢測出微伏(μV)甚至納伏(nV....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-26 09:25
?2155次閱讀
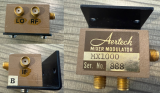
在智能終端輕薄化浪潮中���,集成電路封裝正面臨"尺寸縮減"與"管腳擴容"的雙重擠壓——處理器芯片為處理海....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-26 09:21
?2169次閱讀
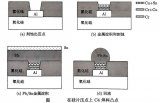
在多芯片封裝趨勢下����,一個封裝內(nèi)集成的高性能芯片日益增多���,熱管理難題愈發(fā)凸顯���?���?諝饫鋮s應對此類系統(tǒng)力不....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-24 16:47
?3088次閱讀
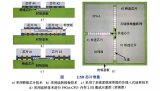
在柔性混合電子(FHE)系統(tǒng)中��,柔性實現(xiàn)的難點在于異質(zhì)材料的協(xié)同工作���。硅基芯片����、金屬互連��、聚合物基板....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-24 14:41
?1865次閱讀

在MEMS中���,玻璃因具有良好的絕緣性��、透光性�、化學穩(wěn)定性及可鍵合性(如與硅陽極鍵合)�����,常被用作襯底、....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-18 15:18
?2255次閱讀
CMP是半導體制造中關(guān)鍵的平坦化工藝�,它通過機械磨削和化學腐蝕相結(jié)合的方式,去除材料以實現(xiàn)平坦化��。然....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-18 15:14
?3024次閱讀
Wafer Acceptance Test (WAT) 是晶圓制造中確保產(chǎn)品質(zhì)量和可靠性的關(guān)鍵步驟�。....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-17 11:43
?3616次閱讀
1997年,富士通公司研發(fā)出一種名為芯片上引線(Lead On Chip�����,LOC)的封裝形式�����,稱作L....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-17 11:41
?4990次閱讀

鋁絲鍵合常借助超聲楔焊技術(shù)���,通過超聲能量實現(xiàn)鋁絲與焊盤的直接鍵合。由于鍵合所用劈刀工具頭為楔形�����,使得....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-16 16:58
?2180次閱讀
在集成MEMS芯片的環(huán)境溫度測量領(lǐng)域��,熱阻、熱電堆和PN結(jié)原理是三種主流技術(shù)����。熱阻是利用熱敏電阻,如....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-16 13:58
?1945次閱讀

這一篇文章介紹幾種芯片加工工藝,在Fab里常見的加工工藝有四種類型,分別是圖形化技術(shù)(光刻)?摻雜技....
![的頭像]() 中科院半導體所 發(fā)表于
中科院半導體所 發(fā)表于 07-16 13:52
?4382次閱讀